
碳化硅(SiC)衬底是第三代半导体材料的核心基础。目前市场上主流的碳化硅衬底尺寸为6至8英寸。广泛应用于新能源、光伏、5G通信、人工智能、物联网等领域。具有高禁带宽度(≤ 3.2eV)、高热导率(4.9W/cm・K)、高击穿电场强(2~4 MV/cm)、高电子饱和漂移速度的特性。
高禁带宽度 | 高热导率 | 高击穿电场强 | 高电子饱和漂移速度 |
禁带宽度达≤ 3.2eV,在高温、高功率应用中优势明显。可提高能源转换效率、降低损耗。 | 热导率为 4.9W/cm・K,散热性能优异,能降低芯片温度、减少热失效风险、延长设备寿命。 | 高击穿电场强度约为 2~4 MV/cm,耐高压能力是硅的10倍,可减少设备体积重量、降低导通电阻、提高稳定性和可靠性。 | 适合高频应用,可减少信号传输延迟、提高速度和质量,与传统硅基射频器件相比,具有更低噪声系数和更高功率附加效率。 |

粉料合成 → 晶体生长 (PVT法)→ 晶锭加工 → 晶圆切片 → 晶圆加工 → 碳化硅衬底
碳化硅粉料合成
高纯碳化硅粉(纯度 99.9999%)与碳源(石油焦或石墨)在高温催化反下合成碳化硅粉末,此粉末是晶体生长的原料,其粒度、纯度直接影响晶体质量。

碳化硅粉料
碳化硅晶体生长
高纯度碳化硅粉末装入等静压石墨坩埚,顶部放置籽晶,在2000°C以上高温,加热升华。固态碳化硅粉末(SiC)升华成Si、Si₂C、SiC₂等气相物质,在惰性气体环境下与籽晶相遇。在籽晶表面结晶生长出单晶。最后通过晶体生长炉利用温度梯度,控制晶体生长的热量传递。缓慢降温,得到圆柱形碳化硅晶锭。

晶体生长的材料与设备
碳化硅晶锭加工
使用X射线衍射确定晶向,标记碳化硅晶锭的切割方位。切除碳化硅晶锭两端(存在多晶或高缺陷区域)。金刚石砂轮将碳化硅晶锭外圆磨削至标准直径。

碳化硅晶锭
碳化硅晶圆切片
用金刚石线锯或内圆切割机,沿着特定的晶向高速切割,将碳化硅晶锭切割成薄片。
碳化硅晶圆加工
研磨、抛光是将碳化硅晶圆表面加工至原子级光滑平面晶圆。承担着高效材料去除和超精密表面成型的核心职能。陶瓷研磨盘表面镀上金刚石涂层研磨使表面粗糙度降至μm级。陶瓷抛光盘,配合精密抛光机,获得纳米级光滑表面。

碳化硅晶圆
碳化硅衬底清洗检测
经过研磨和抛光后的碳化硅衬底,表面虽然已经达到了很高的平整度,但仍然可能残留着一些有机污染物、金属污染物以及微小的颗粒。为了确保衬底的洁净,我们需要进行严格的清洗,确保外延或器件制造的表面质量,清洗后通过形貌、晶体缺陷、电学性能等多维度检测验证碳化硅衬底质量。
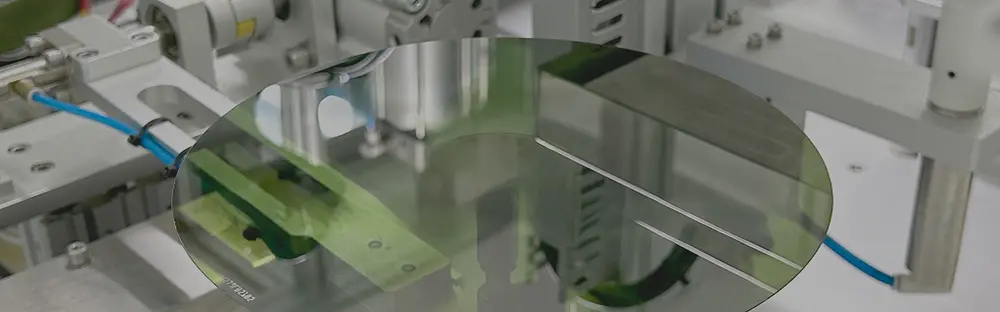
碳化硅衬底

| 8英寸N型碳化硅衬底 - 产品规格 | ||||
| 属性 | 规格 | 单位 | ||
| P | R | D | ||
| 直径 | 200±0.5 | mm | ||
| 厚度 | 500/350(- 25,25) | μm | ||
| 表面偏离晶向 | 4°toward [11-20]±0.5° | |||
| 缺口方向 | Perpendicular to the [11-20]±5° | |||
| 边缘排除 | 3 | mm | ||
| 翘曲度 | ≤40 | ≤100 | μm | |
| 弯曲度 | ±25 | ±60 | ±80 | μm |
| 总厚度偏差 | ≤10 | ≤15 | um | |
| 位错密度-EPD | ≤7000 | ≤12000 | 无要求 | /cm2 |
| 位错密度-TSD | ≤500 | ≤1000 | /cm2 | |
| 位错密度-BPD | ≤1300 | ≤2000 | /cm2 | |
| 微管密度 | ≤1 | ≤5 | /cm2 | |
| 高强度光照多型性 | 4H 100% | 4H 95% | % area | |
| 电阻率 | 0.015-0.028 | Ω .cm | ||
| 表面粗糙度(Si) | <0.2 | nm | ||
| 表面粗糙度(C) | <2 | nm | ||
| 高强度光刻板 | 无 | ≤5ea, Edge 3mm inside, a single size <0.3mm | nm | |
残留金属污染 (Al,Cr, Fe, Ni, Cu, K, Ti &Mn) | <5E10 | <1E11 | atoms/cm2 | |
| 封装 | 多晶圆盒/单晶圆盒 | |||
| 6英寸N型碳化硅衬底 - 产品规格 | ||||||
| 属性 | 规格 | 单位 | ||||
| Z | P | R | D | mm | ||
| 直径 | 150±0.25 | μm | ||||
| 厚度 | 350(-25,25) | |||||
| 表面偏离晶向 | 4.0°towards [11-20]±0.5° | |||||
| 缺口方向 | Perpendicular to the [11-20]±5° | mm | ||||
| 主平面长度 | 47.5 ± 1.5 | mm | ||||
| 边缘排除 | 3 | μm | ||||
| 翘曲度 | ≤25 | ≤35 | ≤45 | ≤60 | μm | |
| 弯曲度 | ±10 | ±15 | ±25 | ±40 | μm | |
| 总厚度偏差 | ≤5 | ≤8 | ≤10 | ≤15 | /cm2 | |
| 位错密度-EPD | ≤4000 | ≤6000 | ≤8000 | ≤ 12000 | 无要求 | /cm2 |
| 位错密度-TSD | ≤200 | ≤300 | ≤500 | ≤800 | /cm2 | |
| 位错密度-BPD | ≤800 | ≤1000 | ≤1500 | ≤2000 | /cm2 | |
| 微管密度 | ≤0.2 | ≤0.2 | ≤0.5 | ≤0.1 | % area | |
高强度光照多型性 | 4H 100% | 4H 98% | 4H 97% | % area | ||
高强度光检测六边形 | 无 | ≤1% | ≤3% | Ω .cm | ||
| 电阻率 | 0.015-0.025 | 0.015-0.028 | 0.010-0.030 | nm | ||
| 表面粗糙度(Si) | <0.2 | nm | ||||
| 表面粗糙度(Si) | <1 | <2 | ||||
| 高强度光检测的裂缝 | 无 | |||||
高强度光检测的硅表面划痕 | 无 | ≤3ea, each ≤10mm | mm | |||
累计划痕长度 (By 8520) | ≤75 | ≤100 | ≤150 | 无要求 | ||
| 边缘缺口 | 无 | |||||
| 边缘轮廓 | SEMI M55-0817 | |||||
| 高强度光检测的污渍 | 无 | |||||
残留金属污染 (Al,Cr, Fe, Ni, Cu, K, Ti &Mn) | < 5E10 | <1E11 | ||||
| 封装 | 多晶圆盒/单晶圆盒 | |||||
| 相关推荐 | |||
| 碳化硅衬底工艺 | 什么是碳化硅 | 低阻碳化硅衬底 | 碳化硅衬底制造设备 |
©2024 上海思莱克工业科技有限公司 版权所有 沪ICP备2024089773号-3 XML站点地图